ЗАНЯТИЕ 5
Поверхностные явлении
Поверхностные состояния
Разглядим процессы на поверхности полупроводника. В 1932 г. советским ученым Таммом было продемонстрировано, что обрыв решетки ведет к происхождению разрешенных уровней в запрещенной территории. Уровни Тамма вероятны для совершенной поверхности полупроводника. Настоящие поверхности покрыты слоем адсорбированных молекул и атомов. Эти примеси кроме этого создают поверхностные уровни, каковые смогут быть как донорными, так и акцепторными. Роль примесей смогут играться и разные недостатки решетки. Разрешенные уровни в запрещенной территории полупроводника на его поверхности именуются поверхностными уровнями либо поверхностными состояниями.
При высокой плотности поверхностных состояний они, взаимодействуя между собой, смогут размыться в поверхностную территорию. Электроны в данной территории смогут двигаться лишь на протяжении поверхности.
Поверхностные состояния смогут захватывать электроны либо напротив отдавать их, заряжаясь положительно либо отрицательно. Заряжение поверхности полупроводника при заполнении поверхностных состояний сопровождается происхождением у поверхности слоя объемного заряда, нейтрализующего поверхностный заряд. Нейтрализация происходит методом притяжения к поверхности носителей со знаком заряда противоположным символу отталкивания носителей и заряда поверхности одного символа. Благодаря этого поверхностный слой обедняется носителями того символа, которым заряжена поверхность и обогащается носителями противоположного символа. Наряду с этим отмечается изгиб территорий и появляется поверхностный объемный заряд. В случае, если поверхность полупроводника заряжена отрицательно, то в приповерхностном слое территории изгибаются вверх, а вдруг положительно то низ.
Эффект поля. МДП-структуры
Измерять объемный поверхностный заряд полупроводника возможно посредством поля, перпендикулярного поверхности. Для для того чтобы поля в полупроводнике, в большинстве случаев, применяют МДП-структуры (рис. 5.1).
В случае, если к совершенной МДП-структуре прикладывается хорошее либо отрицательное напряжение, то в приповерхностной области полупроводника смогут появиться три состояния: обеднение, обогащение и инверсия данной области носителями заряда.
Обедненная главными носителями область появляется при, в то время, когда на железный электрод подается потенциал, по символу совпадающий с главными носителями заряда (рис. 5.1, а и б). Вызванный таким потенциалом изгиб территорий ведет к повышению расстояния от уровня Ферми до дна территории проводимости в полупроводнике n-типа и до потолка валентной территории в полупроводнике p-типа. Повышения этого расстояния сопровождается обеднением приповерхностной области главными носителями.
В то время, когда на железный электрод подается большой потенциал по символу совпадающий с главными носителями (рис. 5.2, в и г), то расстояние от уровня Ферми до потолка валентной территории в полупроводнике n-типа выясняется меньше расстояния до дна территории проводимости (рис. 5.2, г), благодаря чего концентрация не главных носителей заряда (дырок) у поверхности полупроводника делается выше концентрации главных носителей и тип проводимости данной области изменяется. Изменение типа проводимости полупроводника именуется инверсией, а слои, в которых оно отмечается, именуются инверсионными слоями.
В случае, если символ потенциала железного электрода противоположен символу заряда главных носителей тока в полупроводнике, то происходит притяжение главных носителей к поверхности и обогащение ими приповерхностного слоя (рис. 5.2, д и е).
С трансформацией концентрации главных носителей под действием внешнего поля в приповерхностном слое изменяется и проводимость. Явление трансформации поверхностной проводимости под действием поперечного поля именуется эффектом поля.
Полевые транзисторы
Неспециализированные сведения
Основные принципы работы полевого транзистора были созданы Лилиенфельдом и Хейлом в начале 30х годов. Первый МДП-транзистор был изготовлен Кангом и Аталлой в 1960 г. Полевой транзистор с управляющим p-n-переходом был создан Шокли в 1952 г. и изготовлен Дейки и Россом в 1953 г. Полевые транзисторы с диодом Шотки в первый раз были изготовлены на базе арсенида галлия в 1967 г.
Полевые транзисторы содержат три полупроводниковые области исток, канал и сток, конечно управляющий электрод затвор. сток и Исток очень сильно легированные области полупроводника.
По способу и структуре управления проводимостью канала различают три типа полевых транзисторов:
— полевые транзисторы с изолированным затвором, между каналом и металлическим затвором расположен слой диэлектрика (МДП-транзисторы);
— полевые транзисторы с управляющим переходом металл-полупро-водник (с диодом Шоттки), железный электрод затвора образует выпрямляющий контакт с каналом, на что в рабочем режиме подается обратное напряжение;
— полевые транзисторы с управляющем p-n-переходом, в качестве затвора применяют слой полупроводника образующий с каналом p-n-переход, в рабочем режиме имеющий обратное включение
Полевые транзисторы по типу проводимости канала подразделяются на транзисторы с каналом n либо p -типа.
В случае, если канал n-типа, то рабочими носителями являются электроны и на сток подается хороший потенциал. При канала p-типа рабочими носителями являются дырки и на сток подается отрицательный потенциал.
В полевых транзисторах употребляется перемещение носителей заряда одного символа, каковые под действием электрического поля, созданного на протяжении канала, перемещаются от истока к стоку.
Характерной изюминкой полевых транзисторов есть небольшой ток затвора. Входное сопротивление полевых транзисторов на постоянном токе образовывает 108 ¸1010 Ом. Исходя из этого полевые транзисторы являются устройствами, управляемыми напряжением, в отличие от биполярных транзисторов, каковые управляются током.
Статические характеристики
МДП-транзисторов
Выходные чёрта МДП-транзисторов продемонстрированы на рисунке 6.6. На выходные ВАХ значительное влияние оказывают трансформации в структуре канала, появляющиеся с ростом напряжения на стоке.
При UИ=UС=0 электрическое поле в полупроводнике и диэлектрике будет однородным, и толщина канала будет однообразной от истока до стока.
В случае, если напряжение UСИ0 и не весьма громадно, то канал ведет себя как простое сопротивление. Ток стока возрастает пропорционально напряжению стока. Эту область ВАХ именуют линейной областью работы транзистора.
С ростом напряжения UСИ будут возрастать потенциал поверхности и ток стока полупроводника в направлении от истока к стоку. Благодаря этого разность потенциалов между поверхностью полупроводника и затвором будет уменьшаться в направлении к стоку. Соответственно сечение канала начинает сужаться в направлении к стоку. При напряжении на стоке равном напряжению насыщения UСН разность потенциалов между поверхностью полупроводника и затвором делается равной нулю у стока. Толщина канала у стока делается равной нулю. МДП-транзистор переходит в режим отсечки канала. При напряжении UСИUСН точка отсечки сдвигается к истоку и происходит укорочение канала на DL (рис. 6.7). На участке DL обедненный слой выходит на поверхность полупроводника.
По окончании отсечки канала ток стока перестает зависеть от потенциала стока. Эта область ВАХ именуется областью насыщения тока стока.
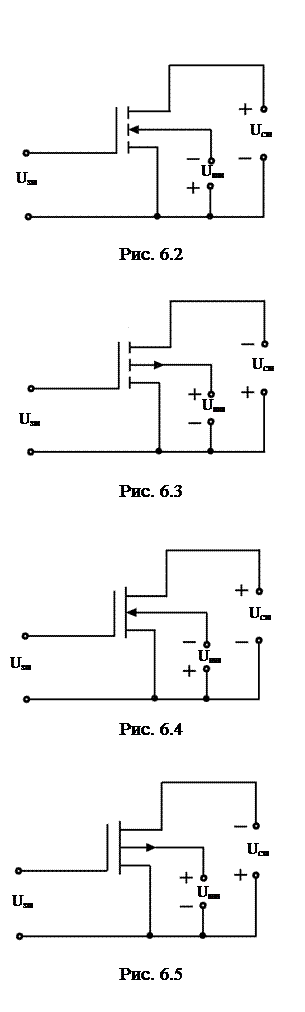 |
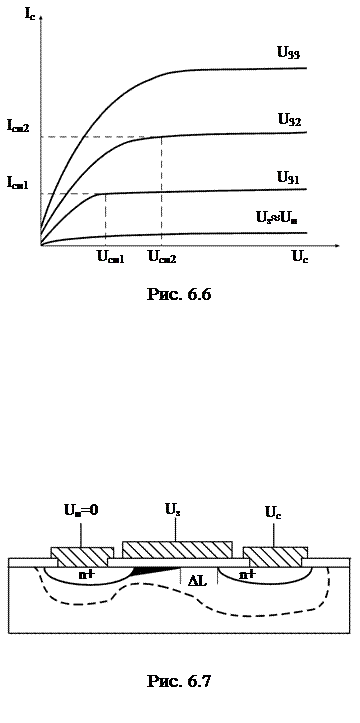 |
На острие канала, в точке его перекрытия концентрируется электрическое поле, напряженность которого делается выше критической и наступает режим насыщения скорости дрейфа электронов, инжектированных из острия канала в обедненный слой.
Ток равен: jn=еmnnEKP,
так как vДР=mnEКР=const n=const,
то и jn=const.
P-n-переходом
Структура для того чтобы транзистора продемонстрирована на рис. 6.8. На подложке p-типа формируется эпитаксиальный n-слой, в котором способами диффузии создаются области истока, стока n+ -затвора и типа p+-типа. Управляющий p-n-переход образуют области p+ и n. Токопроводящим каналом есть эпитаксиальный слой n-типа расположенный между подложкой и затвором. При работе транзистора управляючий p-n-переход должен быть включен в обратном направлении.
Глубина обедненного слоя управляющего p-n-перехода тем больше, чем больше обратное напряжение на затворе. Толщина канала будет кроме этого соответственно меньше. Следовательно с трансформацией обратного напряжения будет изменяться поперечное сечение канала, а следовательно и его сопротивление. При наличии напряжения между истоком и стоком изменяя обратное напряжение на затворе возможно руководить выходным током транзистора.
Входным током транзистора есть обратный ток p-n-перехода, составляющий для кремниевых устройств 10-9-10-11 А.
На сток транзистора подается хорошее напряжение. P-n-переход между эпитаксиальным n-подложкой и слоем включается в обратном направлении, исходя из этого к подложке прикладывается отрицательное относительно истока напряжение. Время от времени подложка употребляется в качестве второго затвора. В некоторых транзисторах подложка соединяется с затвором и не имеет отдельного вывода.
передаточные характеристики и Статические выходные полевых транзисторов с управляющим p-n-переходом продемонстрированы на рис. 6.9 и 6.10.
Выходные чёрта имеют участок насыщения тока, связанный как и у МДП-транзисторов с образованием горловины канала вблизи стока.
Напряжением отсечки полевого транзистора с управляющим p-n-переходом именуется напряжение на затворе, при котором полностью перекрывается ток и канал стока пытается к нулю.
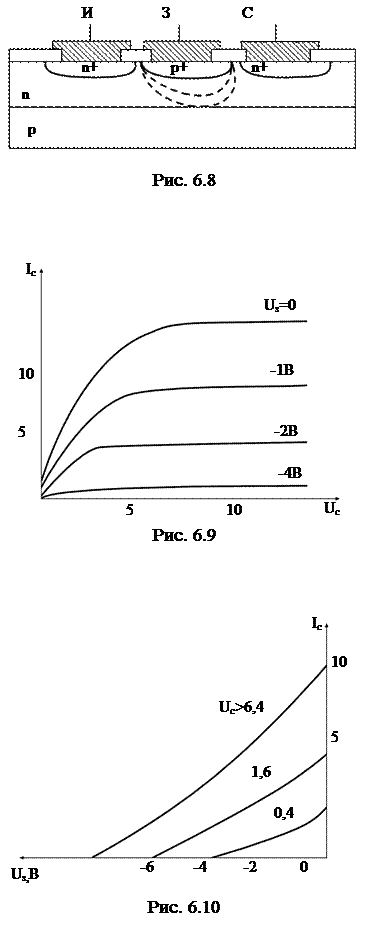 |
Диэлектрические пленки
Главными механизмами переноса заряда, определяющими проводимость изолирующих пленок являются: термополевая эмиссия Шоттки, эмиссия Пула-Френкеля и сильнополевая туннельная инжекция по Фаулеру-Норугейму.
Термополевая эмиссия по Шоттки. Термоэлектронная эмиссия электронов разъясняется наличием высокоэнергетического «хвоста» в распределении электронов по энергии.
Термоэлектронная эмиссия – это испускание электронов нагретым телом в вакууме (рис.7.5).
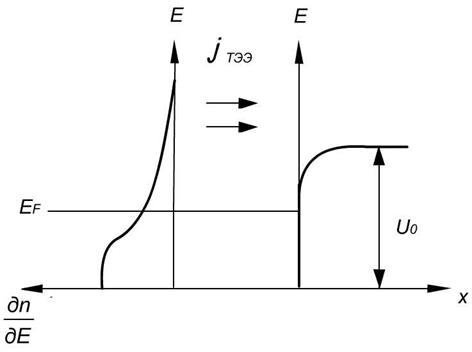
Рис. 7.5
При наложении внешнего электрического поля происходит понижение потенциального барьера, разделяющего диэлектрик и металл. Это явление именуется эффектом Шоттки.
Понижение потенциального барьера происходит в следствии сложения потенциала внешнего поля u?=q?x с потенциалом u0 на границе металл-диэлектрик, определяемым силами зеркального изображения (рис.7.6).
Термополевая эмиссия Шоттки представляет собой надбарьерную термоэлектронную эмиссию, облегченную за счет наложения внешнего электрического поля. Эмиссия Шоттки есть одним их главных механизмов переноса зарядов в совокупностях металл-диэлектрик-металл и металл-полупроводник-металл.

Рис. 7.6
Плотность тока эмиссии по Шоттки равна:
 ,
,
где А=12•105А /см2•град2/ — постоянная Ричардсона. ?В – высота потенциального барьера.
Эмиссия Пула-Френкеля. В диэлектрических слоях, содержащих много структурных примесей и дефектов, имеется высокая концентрация ловушек, талантливых захватывать носители.
Сильное электрическое поле может привести к активации свободных носителей заряда в самой диэлектрической пленки рис. 7.7. Эмиссия Пула-Френкеля это ускоренный электрическим полем процесс термовозбуждения электронов с ловушек в зону проводимости диэлектрика.

Рис. 7.7
Плотность тока эмиссии по Пулу-Френкелю равна
 ,
,
где В – коэффициент пропорциональности, ?в – глубина ловушки.
Зависимости плотностей токов эмиссий по Шоттки и Пулу-Френкелю спрямляются в координатах lg j=f .
Токи эмиссий Шоттки и Пула-Френкеля во многом зависят от температуры.
Литература
1. Пасынков В.В., Чиркин Л.К. Полупроводниковые устройства. СПб.: Издательство Лань, 2001.
2. Степаненко И.П. Базы микроэлектроники. М.: Лаборатория базисных знаний, 2004.
3 Гуртов В.А. Твердотельная электроника. М.: Техносфера, 2007.
4. Ефимов И.Е., Козырь И.Я., Горбунов Ю.И. Микроэлектроника. М.: Верховная школа, 1986.
5. Епифанов Г.И., Мома Ю.А. Твердотельная электроника. М.: Верховная школа, 1986.
6. Опадчий Ю.Ф., Глудкин О.П., Гуров А.Л. Аналоговая и цифровая электроника. М.: «Горячая Линия – Телеком», 1999.
7. Базы радиоэлектроники. Под ред. Г.Д. Петрухина М.: Издательство МАИ, 1993.
8. Киселев В.Ф., Козлов С.Н., Зотеев А.В. Базы физики поверхности жёсткого тела. М.: Издательство МГУ, 1999 г.
9. Зи С. Физика полупроводниковых устройств. М.: Мир, 1984.
Приложение 1
Элементы квантовой механики и физической статистики
При физическом описании особенностей жёстких тел активно применяются квантомеханические и статические представления. Дабы избежать бессчётных ссылок на курс физики при изложении данного курса изложим главные положения квантовой механики и статической физики в краткой конспективной форме.
Волновые особенности частиц
К 20 веку было обнаружено, что ядерные явления не смогут быть обрисованы ни как перемещение частиц, ни как чисто волновые процессы. Так в явлениях дифракции, интерференции проявляется волновая природа света. В фотоэлектрических явлениях, эффекте Комптона (изменение частоты либо длины волны фотонов при их рассеянии электронами) свет ведет себя как частица. В первой половине 20-ых годов двадцатого века французский физик де Бройль выдвинул догадку, что с каждым телом должна быть связана плоская волна.
 ,
,
где h – 6,6·10-34 Дж·с – постоянная Планка, p – импульс.
Догадка де Бройля взяла убедительное экспериментальное подтверждение. На волновых особенностях микрочастиц основана электронная микроскопия, нейтронография. Микрочастицы – электроны, протоны нельзя представить в виде дробинки, сниженной до соответствующих размеров. Качественным отличительным показателем микрочастиц есть органическое сочетание в них корпускулярных и волновых особенностей.
Уравнение Шредингера.
Потому, что микрочастицы владеют волновыми особенностями, то и закон их перемещения обязан описываться волновым уравнением. В первый раз такое уравнение было записано Эрвином Шредингером (Австрия). Для микрочастицы, движущейся в силовом поле и владеющей потенциальной энергией u(x,y,z,t) оно имеет форму:
 ,
,
где i= , -постоянная Планка, дроблённая на 2p.
Функция ?(x,y,z,t) есть ответом этого уравнения и именуется волновой функцией. Она имеет следующий физический суть: произведение ? на функцию ?* комплексно сопряженную с ? пропорционально возможности того, что в момент времени t, микрочастица возможно найдена в выделенном количестве dV. Обозначим возможность обнаружения микрочастицы в количестве dV через ?(x,y,z,t) dV. Тогда:
?(x,y,z,t)dV= ?(x,y,z,t)?*(x,y,z,t)dV.
Интеграл , забранный по всему количеству равен 1, т.к. он высказывает точный факт, что микрочастица находится в этом количестве. Следовательно:
.
Это условие именуется условием нормировки, а волновые функции, удовлетворяющие ему, именуются нормированными.
Закон перемещения микрочастицы всегда определяется заданием функции ? в любой момент времени в каждой точке пространства.
Потенциальная энергия в общем случае есть функцией координат и времени. Но в большинстве практических задач u есть функцией лишь координат. В этом случае волновую функцию ?(x,y,z,t) воображают в виде произведения функций ?(x,y,z) и ?(t):
?(x,y,z,t) = ?(x,y,z)· ?(t). (1)
Разглядим перемещение микрочастицы на протяжении оси Х. Тогда уравнение Шредингера возможно записать:
 . (2)
. (2)
Подставим (2) в (1):
 .
.
Делим обе части на :

Тогда левая часть уравнения зависит лишь от t, а правая лишь от х. Они могут быть равны друг другу лишь в том случае, если любая равна одной и той же постоянной величине Е. Возможно продемонстрировать, что эта величина Е, имеется полная энергия частицы Е. Возможно записать приравнивая левую и правую части уравнения –Е:
 , откуда
, откуда
 . (3) (3)
. (3) (3)
 , откуда
, откуда
 . (4)
. (4)
В общем случае уравнение (3) будет содержать вторые производные по вторым координатам:
 . (5)
. (5)
Через оператор Лапласа это уравнение возможно записать так:
 .
.
Функция ?(x,y,z) зависящая лишь от координат именуется амплитудной волновой функцией, а уравнение (5) амплитудным уравнением Шредингера.
Было доказано, что при перемещении микрочастицы в ограниченной области пространства амплитудное уравнение Шредингера имеет ответ лишь при определенных значениях энергии Е – Е1, Е2…Еn, именуемых собственными значениями энергии частицы. Волновые функции ?1, ?2, ?3,… ?n, соответствующие этим энергиям, именуются собственными волновыми функциями.
Ответом уравнения (4) есть:
 ,
,
где Еn – одно из собственных значений энергии. Функция ?(t) высказывает зависимость волновой функции ?(x,y,z,t) от времени. Эта зависимость есть гармонической с частотой ?n=Еn / h либо  .
.
В случае, если потенциальная энергия есть функцией лишь координат, то ответ уравнения Шредингера возможно представлено в виде:
?(x,y,z,t)= ?(x,y,z)exp(-i?t).
В этом случае возможность обнаружения частицы в элементе количества равна:
?dV=??*dV
и не зависит от времени. Следовательно, распределение возможности в пространстве есть стационарным. Состояния микрочастиц, удовлетворяющие этому условию, именуются стационарными состояниями. Амплитудное уравнение обрисовывает стационарное состояние микрочастиц.
Соотношения неопределенности Гейзенберга
К микрочастицам, владеющим волновыми особенностями, использовать понятия классической механики, к примеру ее координат импульса и понятия частицы возможно только в ограниченной степени.
Пускай частица движется на протяжении оси Х и владеет импульсом рх. Таковой частице соответствует волна ?=h/px, являющаяся по собственной сущности протяженным объектом. Монохроматическая волна простирается по оси Х от -? до +?. Следовательно, промежуток локализации микрочастицы ?х равен бесконечности. Т.е. микрочастица, имеющая определенный импульс рх, не имеет определенной координаты х. Возможно продемонстрировать, что микрочастица, имеющая определенную координату, не имеет определенного импульса. В отличие от хорошей частицы состояние микрочастицы не может быть охарактеризовано заданием одновременно определенных координат и составляющих импульса. Задать состояние микрочастицы возможно только допуская неопределенность в значениях и значениях координат составляющих импульса. Количественно эта неопределенность описывается соотношениями записанными Гейзенбергом в 1927г.
?x??px ? h; ?y??py ? h; ?z??pz ? h,
т.к. p=m?v, то
?x??vx ? ; ?y??vy ? ; ?z??vz ? .
Из соотношений неопределенности направляться, что чем правильнее определяются координаты микрочастицы, тем неизвестнее становятся составляющие импульса. Исходя из этого бессмысленно сказать о траектории перемещения микрочастицы, т.е. о совокупности положений движущейся частицы в пространстве.
Соотношение неопределенности существует и между временем и энергией:
?Е??t ? h ,
где ?t – время, за который частица владеет энергией Е ?Е.
Из соотношения неопределенности для энергии и времени направляться, что неопределенность энергии возрастает при уменьшении времени нахождения микрочастицы в данном энергетическом состоянии.
Потенциальные преграды для микрочастиц
ямы и Потенциальные барьеры для микрочастиц появляются, к примеру, благодаря электрического сотрудничества электронов с ионами решетки в жёстком теле, на границах раздела тел. Изменение потенциальной энергии частицы в зависимости от ее координат представляет собой потенциальный рельеф для данной частицы в заданном количестве. В кристаллах отмечается периодический потенциальный рельеф, что в несложном случае возможно представить в виде совокупности одномерных прямоугольных барьеров, поделённых прямоугольными ямами.
Приложение 2
ЗАНЯТИЕ 5
Поверхностные явлении
Поверхностные состояния
Разглядим процессы на поверхности полупроводника. В 1932 г. советским ученым Таммом было продемонстрировано, что обрыв решетки ведет к происхождению разрешенных уровней в запрещенной территории. Уровни Тамма вероятны для совершенной поверхности полупроводника. Настоящие поверхности покрыты слоем адсорбированных молекул и атомов. Эти примеси кроме этого создают поверхностные уровни, каковые смогут быть как донорными, так и акцепторными. Роль примесей смогут играться и разные недостатки решетки. Разрешенные уровни в запрещенной территории полупроводника на его поверхности именуются поверхностными уровнями либо поверхностными состояниями.
При высокой плотности поверхностных состояний они, взаимодействуя между собой, смогут размыться в поверхностную территорию. Электроны в данной территории смогут двигаться лишь на протяжении поверхности.
Поверхностные состояния смогут захватывать электроны либо напротив отдавать их, заряжаясь положительно либо отрицательно. Заряжение поверхности полупроводника при заполнении поверхностных состояний сопровождается происхождением у поверхности слоя объемного заряда, нейтрализующего поверхностный заряд. Нейтрализация происходит методом притяжения к поверхности носителей со знаком заряда противоположным символу отталкивания носителей и заряда поверхности одного символа. Благодаря этого поверхностный слой обедняется носителями того символа, которым заряжена поверхность и обогащается носителями противоположного символа. Наряду с этим отмечается изгиб территорий и появляется поверхностный объемный заряд. В случае, если поверхность полупроводника заряжена отрицательно, то в приповерхностном слое территории изгибаются вверх, а вдруг положительно то низ.
Эффект поля. МДП-структуры
Измерять объемный поверхностный заряд полупроводника возможно посредством поля, перпендикулярного поверхности. Для для того чтобы поля в полупроводнике, в большинстве случаев, применяют МДП-структуры (рис. 5.1).
В случае, если к совершенной МДП-структуре прикладывается хорошее либо отрицательное напряжение, то в приповерхностной области полупроводника смогут появиться три состояния: обеднение, обогащение и инверсия данной области носителями заряда.
Обедненная главными носителями область появляется при, в то время, когда на железный электрод подается потенциал, по символу совпадающий с главными носителями заряда (рис. 5.1, а и б). Вызванный таким потенциалом изгиб территорий ведет к повышению расстояния от уровня Ферми до дна территории проводимости в полупроводнике n-типа и до потолка валентной территории в полупроводнике p-типа. Повышения этого расстояния сопровождается обеднением приповерхностной области главными носителями.
В то время, когда на железный электрод подается большой потенциал по символу совпадающий с главными носителями (рис. 5.2, в и г), то расстояние от уровня Ферми до потолка валентной территории в полупроводнике n-типа выясняется меньше расстояния до дна территории проводимости (рис. 5.2, г), благодаря чего концентрация не главных носителей заряда (дырок) у поверхности полупроводника делается выше концентрации главных носителей и тип проводимости данной области изменяется. Изменение типа проводимости полупроводника именуется инверсией, а слои, в которых оно отмечается, именуются инверсионными слоями.
В случае, если символ потенциала железного электрода противоположен символу заряда главных носителей тока в полупроводнике, то происходит притяжение главных носителей к поверхности и обогащение ими приповерхностного слоя (рис. 5.2, д и е).
С трансформацией концентрации главных носителей под действием внешнего поля в приповерхностном слое изменяется и проводимость. Явление трансформации поверхностной проводимости под действием поперечного поля именуется эффектом поля.
Вольт-фарадная черта
Разглядим емкость МДП-стуктуры с полупроводником n-типа при трансформации напряжения смещения на железном электроде при наложении переменного сигнала.
В режиме обогащения в МДП-структуре с полупроводником n-типа (плюс на железном электроде) электроны притягиваются к поверхности и в приповерхностном слое полупроводника появляется заряд QS притянутых электронов, по величине равный заряду QМ, индуцируемому на железном электроде (рис. 5.3). С повышением напряжения толщина заряженного слоя сохраняется фактически неизменной и рост заряда QS является следствием увеличения объемной плотности. Исходя из этого емкость структуры не зависит от приложенного напряжения.
В состоянии обеднения электроны отгоняются от поверхности полупроводника и в приповерхностном слое образуется неподвижный заряд ионизированных доноров QС= qNДdП, где dОПЗ- толщина области поверхностного заряда (ОПЗ) (рис. 5.4). Емкость таковой структуры будет складываться из емкостей двух последовательно соединенных конденсаторов: конденсатора образованного диэлектрическим слоем dД и конденсотора образованного обедненным слоем dОПЗ.
Емкости этих конденсаторов при единичной площади равны:
СД=  , СОПЗ=
, СОПЗ=  .
.
Емкость СОПЗ зависит от падающей на полупроводнике разности потенциалов, поскольку с ее трансформацией изменяется толщина обедненного слоя dОПЗ, играющая роль расстояния между обкладками конденсатора.
Емкость структуры в целом будет равна:
 , (5.3.1)
, (5.3.1)
С=  . (5.3.2)
. (5.3.2)
С ростом напряжения смещения ширина ОПЗ возрастает, благодаря чего емкость СОПЗ значительно уменьшается. Наряду с этим значительно уменьшается и неспециализированная емкость. Это происходит до наступления инверсии. В состоянии инверсии к поверхности полупроводника притягиваются дырки, образуя хороший заряд QР рис. 5.5. До наступления инверсии рост заряда в полупроводнике QП определяется ростом заряда ОПЗ и повышением dОПЗ, а по окончании наступления инверсии- ростом заряда QР. Потому, что толщина инверсного слоя, образованного дырками практически не зависит от приложенного напряжения, то в состоянии инверсии емкость структуры не зависит от напряжения.
На рис. 5.6 продемонстрированы вольт-фарадные характеристики МДП-структуры. Минимум кривой С=f(U) соответствует образованию инверсного слоя и характеризуется напряжением инверсии Uuн. При высокочастотном сигнале не главные носители, в этом случае дырки, не успевают смотреть за знаком, исходя из этого емкость полупроводника определяется емкостью ОПЗ и не зависит от заряда дырок, а так как по окончании образования инверсного слоя ширина ОПЗ не изменяется, то и С=f(U) остается постоянной. При низкочастотном сигнале не главные носители успевают следовать за переменным напряжением и емкость полупроводника определяется в этом случае зарядом дырок в инверсном слое, что скоро растет с напряжением. Следовательно возрастает и неспециализированная емкость структуры, впредь до С@СД. После этого С не изменяется с ростом напряжения, поскольку емкость структуры определяется емкостью СД, которая в этом случае меньше СП емкости полупроводника.

роль расстояния между обкладками конденсатора. 
 |
Не считая рассмотренных в МДП-структуре может появляться заряд на поверхностных состояниях QSS и заряд в диэлектрике, что ведет к сдвигу ВФХ вправо либо влево по оси напряжений.
Полевые транзисторы
Неспециализированные сведения
Основные принципы работы полевого транзистора были созданы Лилиенфельдом и Хейлом в начале 30х годов. Первый МДП-транзистор был изготовлен Кангом и Аталлой в 1960 г. Полевой транзистор с управляющим p-n-переходом был создан Шокли в 1952 г. и изготовлен Дейки и Россом в 1953 г. Полевые транзисторы с диодом Шотки в первый раз были изготовлены на базе арсенида галлия в 1967 г.
Полевые транзисторы содержат три полупроводниковые области исток, канал и сток, конечно управляющий электрод затвор. сток и Исток очень сильно легированные области полупроводника.
По способу и структуре управления проводимостью канала различают три типа полевых транзисторов:
— полевые транзисторы с изолированным затвором, между каналом и металлическим затвором расположен слой диэлектрика (МДП-транзисторы);
— полевые транзисторы с управляющим переходом металл-полупро-водник (с диодом Шоттки), железный электрод затвора образует выпрямляющий контакт с каналом, на что в рабочем режиме подается обратное напряжение;
— полевые транзисторы с управляющем p-n-переходом, в качестве затвора применяют слой полупроводника образующий с каналом p-n-переход, в рабочем режиме имеющий обратное включение
Полевые транзисторы по типу проводимости канала подразделяются на транзисторы с каналом n либо p -типа.
В случае, если канал n-типа, то рабочими носителями являются электроны и на сток подается хороший потенциал. При канала p-типа рабочими носителями являются дырки и на сток подается отрицательный потенциал.
В полевых транзисторах употребляется перемещение носителей заряда одного символа, каковые под действием электрического поля, созданного на протяжении канала, перемещаются от истока к стоку.
Характерной изюминкой полевых транзисторов есть небольшой ток затвора. Входное сопротивление полевых транзисторов на постоянном токе образовывает 108 ¸1010 Ом. Исходя из этого полевые транзисторы являются устройствами, управляемыми напряжением, в отличие от биполярных транзисторов, каковые управляются током.